QFNパッケージングプロセスにおけるモールドリリースフィルム:包括的なガイド
2023/07/26

1. 序論
Quad Flat No-leads(QFN)は、コンパクトでロープロファイルの統合回路(IC)パッケージングフォーマットで、特にスペースと重量が重要な電子工業で広く利用されています。 "QFN"という用語は、パッケージの四辺フラットデザインと、突出したリードまたはピンがないことを表しています。代わりに、電気的な接続はパッケージの底部の金属パッドを介して確立されます。この設計アプローチにより、フットプリントを小さくすることができ、QFNを密に配置されたプリント回路ボードに最適なものにします。QFNパッケージングは、ICから発生する熱を底部の熱パッドを介して効率的にボードに伝えることで優れた熱性能を提供します。この費用対効果の高いパッケージングは、他の多くのフォーマットよりも材料が少なく、組み立てプロセスが簡単です。
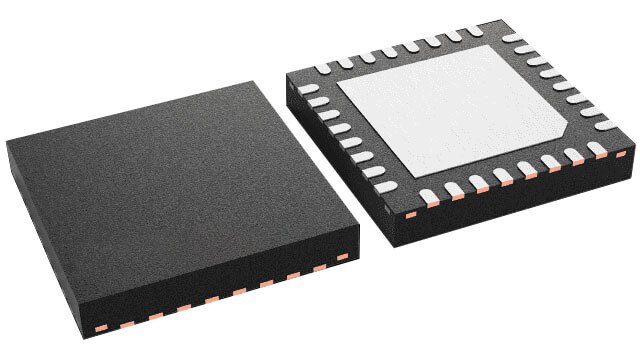
2. QFNパッケージングの詳細な分析
Quad Flat No-Leads(QFN)パッケージングは、集積回路(IC)用のサーフェスマウントテクノロジー(SMT)パッケージングの一種です。これは突出したリードやピンのない正方形または長方形のパッケージです。代わりに、プリント基板(PCB)への電気的な接続のために裏面にメタルパッドが特徴となっています。電子機器に対するミニチュア化の需要が絶えず増加する中、QFNパッケージングは、古い技術と比べて、熱の放散、コンパクトさ、コスト効率を向上させるために進化してきました。
主な利点
- コンパクトなデザイン:小さいフットプリントにより、スマートフォンや他のコンパクトなデバイスなどの高密度PCBに最適です。
- 優れた熱および電気性能:パッケージ底部の熱パッドにより、QFNパッケージは優れた熱伝導性を提供します。これにより、効果的に熱を放散します。短いリード長はリードのインダクタンスを低下させ、電気性能を向上させます。
- コスト効率:材料と組立工程が少なくなることで、QFNパッケージングは大幅なコスト削減をもたらす可能性があります。また、標準的なSMTプロセスと互換性があるため、生産コストが削減されます。
QFNパッケージングプロセス
- ダイアタッチ:プロセスは、ダイアタッチ材を使用して、シリコンダイをリードフレーム(ダイから外部への信号を伝える金属構造)に取り付けることから始まります。
- ワイヤーボンディング:超細金またはアルミニウムワイヤーが使用され、ダイのボンディングパッドをリードフレームのダイパッドに接続します。
- モールド化合物:ダイとワイヤーボンドは、物理的な損傷や環境汚染から保護するための保護モールド化合物に封入されます。
- シングレーション:成形されたパッケージは、シングレーションと呼ばれるプロセスを通じて個々のユニットに分けられます。
- 表面仕上げ:酸化を防ぎ、はんだ付け性を向上させるために、露出した銅リードフレームに表面仕上げが施されます。
- 最終テスト:完成したQFNパッケージは、機能、性能、および信頼性についてテストされます。
3. モールドリリースフィルムの核理論
型解放フィルムの目的と応用
型解放フィルムの使用は、QFNパッケージングを含むさまざまな製造プロセスで基本的です。型解放フィルムの背後にある中心理論は、金型と成形される材料(この場合は、カプセル化される樹脂)との間の接着力を減らし、製品の滑らかなリリースを容易にすることに関与しています。
動作原理
型解放フィルムは、表面張力を減らす原理に基づいて動作します。表面張力は、液体の表面が可能な限り最小の表面積に収縮する原因となる力です。この表面張力を減らすことで、型解放フィルムは、カプセル化材料が金型表面に付着するのをより困難にし、脱型プロセスを容易にします。
タイプと構成
幅広いアプリケーションに合わせて設計された型解放フィルムは、主に低表面エネルギーの材料で構成され、その結果自然に接着に対する耐性が保証されます。材料の選択は特定のアプリケーションに依存し、通常はその優れた特性のために、非シリコンベースの材料、ETFE、PTFE、およびその他の専有ブレンドが含まれます。
シリコンベースのフィルムはその型解放特性のために一部のアプリケーションで使用されるにもかかわらず、いくつかの理由により、一般的にはQFNパッケージングで使用されません:
シリコンベースのリリースフィルムは、成形解除プロセス中に部品に望ましくないシリコン残留物を導入する可能性があります。これらの残留物は、ワイヤーボンディング、アンダーフィル、またはコンフォーマルコーティングなどの後続プロセスを妨げ、全体のデバイスの故障につながる可能性があります。
シリコンベースのフィルムは、QFNカプセル化プロセスで使用される溶剤や樹脂と互換性がない場合があります。この互換性がないと、接着や潜在的な化学反応の問題が発生し、パッケージの整合性を損なう可能性があります。
QFNパッケージングでの応用
QFNパッケージングプロセスでは、型解放フィルムは型とカプセル化樹脂の間にバリアを形成します。フィルムの非粘着性が樹脂が型に粘着しないことを保証し、パッケージ化された半導体デバイスの滑らかな解放を可能にします。
型解放フィルムの使用は、QFNパッケージングプロセスの効率を高めるだけでなく、型の寿命を延ばすのにも役立ちます。樹脂が型に粘着するのを防ぐことにより、型の摩耗と磨耗を減らし、メンテナンスコストとダウンタイムを削減します。
成形解放フィルムの種類と性能比較
| PET/PENフィルム | ETFEフィルム | PTFE Films | |
|---|---|---|---|
| 接着性(リリース特性) | 高い | 並外れた | 優れている |
| 温度抵抗 | 中程度 | 優れた | 並外れた |
| 耐久性(引裂き抵抗) | 中程度 | 優れた | 高い |
| 汚染の可能性(残留物) | 低い | 低い | Very Low |
| 化学的な互換性 | 高い | 優れている | 優れた |
| コスト | 低い | 高い | 高い |
特定の用途、製造過程、成形する材料によって、理想的な型解放フィルムの種類が変わることを理解することが重要です。温度、圧力、化学的適合性、成形製品の所望の表面仕上げなどの要素を考慮して最適な型解放フィルムを選択する必要があります。
関連製品: PET/PEN モールドリリースフィルム
4. QFNパッケージングプロセスにおけるモールドリリースフィルム

ステップ1. フィルムの取り入れ:
この最初のステップでは、成形解放フィルムが導入されます。これは、成形キャビティがある機械にフィルムロールを供給することを含む可能性があります。フィルムは、全体がカバーされるように成形の寸法に応じてカットされます。
ステップ2. フィルムの真空成形
フィルムが所定の位置にあると、真空を用いて金型の形状に成形されます。これにより、フィルムが金型の表面に適切に密着し、必要な全ての領域をカバーし、ノンスティック表面を提供します。
ステップ3. リードフレームのロード:
リードフレーム(半導体チップとワイヤーボンドを保持する)が次に金型キャビティにロードされます。これが金型のキャビティと一致するように正確に整列することが確認されます。
ステップ4. 金型の閉じ込め:
次に金型が閉じられ、内部のリードフレームが密閉されます。これにより、最終製品の正しい形状が保証され、次の充填プロセス中の微細構造が保護されます。
ステップ5. キャビティの充填:
次に、金型キャビティにプラスチック化合物、通常はエポキシ樹脂が充填されます。この化合物は加熱し、加圧されてキャビティの全域に流れ込み、リードフレームをカプセル化し、QFNパッケージのボディを形成します。
ステップ6. 金型の開放:
金型化合物が完全に硬化したら、金型を開きます。成型離型フィルムのおかげで、完成したQFNパッケージは金型表面に固着せず、容易かつ清潔に取り外すことができます。
ステップ7. 成形製品の取り出し:
つぎに、成形されたQFNパッケージが金型から取り出されます。成型離型フィルムはスムーズな離型を保証し、パッケージへの損傷リスクを軽減します。残存するフィルムは容易に取り外すことができ、次のサイクルに向けて金型を準備します。
これらの手順は、成形されたパッケージが正確かつ効率的に作成されることを確保し、一方で、成型離型フィルムは金型からの簡単な取り外しと最終製品の品質に大いに貢献します。
5. 適切なモールドリリースフィルムの選び方
フィルムは、使用している特定の種類の成型化合物と互換性があるべきです。つまり、化合物と化学反応せず、化合物を硬化するための条件下で離型性能を保持することを意味します。
成型離型フィルムは、成型プロセスで使用される温度と圧力に耐えることができ、劣化したり離型性能を失ったりすることなく、その性能を保つべきです。
良い成型離型フィルムは、成形されたパッケージを金型から簡単かつ清潔に取り外すことができるように、優れた非粘着性を持つべきです。
これは、成形リリースフィルムが破断するまでに耐えられる引張力の尺度です。引張強度が高いフィルムは、成形プロセス中に裂けたり、破れたりする可能性が低く、金型と成形される製品を適切に保護できます。
これは、成形リリースフィルムが破断する前にどの程度伸びるかを示し、パーセンテージで表されます。破断時の伸び率が高いということは、フィルムが非常に柔軟で、ストレス下で破断せずに変形できることを意味します。これは、成形プロセスが大幅な形状変化やカバーすべき不規則な表面を伴う場合に特に重要です。
一部の成形リリースフィルムは、交換が必要になる前に複数回使用することができます。これにより、コストを削減し、効率を向上させることができます。ただし、フィルムは引き続き良好なリリース特性を提供し、金型や成形されたパッケージに残留物を残さないようにする必要があります。
コストは主要な決定要因であるべきではありませんが、それでも考慮するべきです。あなたの生産のボリュームと精度によりますが、性能が良くて長持ちする高価なフィルムが長期的には実際にコスト効果が高いかもしれません。
型離れフィルムは、型に簡単に適用し形成することができるべきです。すばやく簡単に適用できるフィルムは、生産プロセスの効率を向上させるのに役立つことができます。
フィルムの環境への影響を考慮します。一部のフィルムは、環境に優しい材料から作られているか、リサイクル可能である可能性があり、それは今日のますますエコ意識の強い世界では大きな利点となる可能性があります。
結論として、適切な型離れフィルムを選ぶことは、その機械的特性、性能特性、コスト、および成形プロセスの特定の要件との間のバランスをとる行為です。最適なフィルムを見つけるためには、いくつかのテストと実験が必要になる場合があります。
6. モールドリリースフィルムがQFNパッケージング品質に与える影響
QFNパッケージング品質について:
型離れフィルムの主な目的は、成形されたパッケージを型から簡単にかつきれいに取り外すことを容易にすることです。これにより、パッケージの完全性が確保され、型離れ時の損傷リスクが減少します。
型からの離型フィルムは、型材料が型表面に付着するのを防ぐことで、パッケージの滑らかな表面仕上げに寄与します。
離型フィルムは、パッケージの精度を維持するのに役立ちます。パッケージが型に付着している場合、取り外し時に歪む可能性があり、その結果、寸法や精度に影響を及ぼす可能性があります。
型の寿命について:
離型フィルムを使用すると、型表面の摩耗と破損が減ります。成形パッケージが取り外されるたびに、型表面が劣化するリスクがあります。特にパッケージが型にくっついている場合には、離型フィルムを使用することで、この問題を防ぎ、型の寿命を延ばすことができます。
離型フィルムを使用すると、型のクリーニングが容易になります。成形材料の残留物は簡単に拭き取ることができ、型を傷つける可能性のある強力なクリーニング方法の必要性を減らします。
一部の成形化合物は、時間とともに金型材料と反応し、腐食や他の種類の劣化を引き起こす可能性があります。離型フィルムは、金型表面と化合物との間にバリアを提供し、金型を保護することができます。
結論として、QFNパッケージングプロセスにおいて離型フィルムを使用することは、最終製品の品質を大幅に向上させ、金型の寿命を延ばすことができます。したがって、適切な離型フィルムを選ぶことは、成形プロセスを最適化するための重要なステップです。
